

进一步实现超薄晶圆的高速处理
Φ300 mm
DBG
SDBG
Wafer Thinning
实现高良率的薄型化技术
DFM2800是为了处理Φ300 mm超薄晶圆,特意与背面研削机组成联机系统的晶圆贴膜机。针对DGP8761研削薄化后的晶圆,可安全可靠地实施,从粘贴切割胶膜到框架上,到剥离表面保护胶膜为止的一系列工序。本设备还可对应SiP(System in Package)制造中必不可少的切割胶膜一体化的DAF(Die Attach Film)。
可对应25 μm以下的超薄晶圆
为了满足Φ300 mm25 μm以下厚度的薄型化要求,把设备内部的晶圆搬运次数降低为以往机型的1/5,以抑制超薄晶圆的破损风险。另外还在各搬运垫/台上配置了清洗机构,防止因微尘粒子嵌入而导致的晶圆破损。
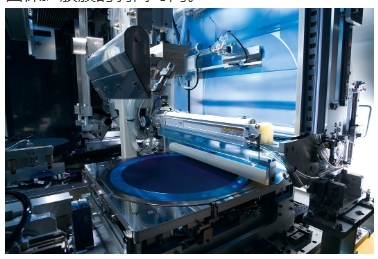
高生产效率
通过优化各搬运部分,连续工作时最大生产效率增加约50 % ※,有助于提高生产性。(与DFM2700相比较)
※实际的生产效率取决于晶圆的贴膜时间及表面保护胶膜的剥离时间。
丰富的特殊选配
单机使用时的机械手臂/晶圆装载机构(Load Port)
设备内部对切割胶膜进行预切割的机构
通过黏性胶膜来剥离表面保护胶膜的机构
为实现贴膜后晶圆的条形码管理的晶圆表面ID识别机构(Vision system)
操作简便
在传承了DFM2700操作方式的同时,进一步扩大了操作画面尺寸,提高了画面的辨识性。另外,在与DGP8761的联机系统中,可以由DGP8761选择DFM2800的加工程序,可对开始/结束等进行一元化管理。
咨询电话:13522079385
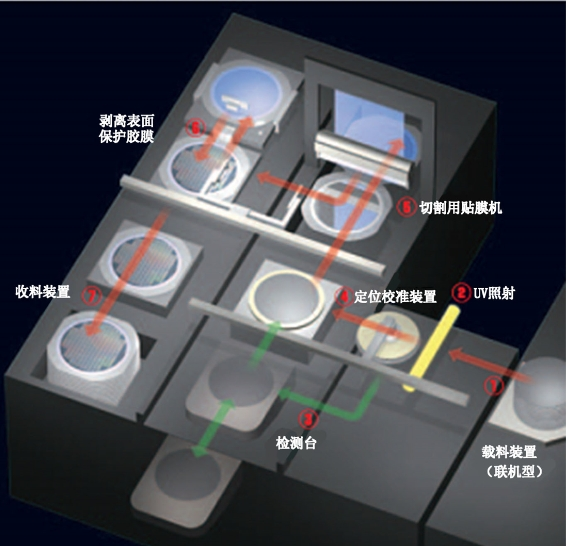
工作流程系统
接受从背面研削机传送过来的加工物 →
对表面保护胶膜进行UV(紫外线)照射(在使用UV胶膜时)→
将加工物搬运到检测台上(任意选项)→
由影像处理实施定位校准作业 →
使用切割胶膜或者 2 in 1 DAF胶膜,将加工物粘贴到胶膜框架上 →
剥离表面保护胶膜 →
放入胶膜框架晶圆盒
技术规格
Specification Unit
Supported workpiece size mm Φ200 / Φ300
Wafer attachment precision and X/Y direction (frame mount) mm ±0.5 or less
Wafer attachment precision and θ direction (frame mount) deg ±0.5 or less
Dicing tape attachment precision and X/Y direction mm ±1.0 or less
Equipment dimensions(W×D×H) mm 2,150 × 2,643 × 1,800
Equipment weight kg Approx.3,100
※为了改善,机器的外观,特征,规格等本公司可能在未预先通知用户的情况下实施变更。
※使用时,请先确认标准规格书。