

在半导体产业的浩瀚星空中,切磨抛技术作为关键一环,直接影响着芯片制造的精度与效率。今天,我们特别聚焦国际巨头DISCO的发展轨迹,探讨其在半导体切磨抛装备材料领域的成就,以及由此引发的国产化趋势浪潮。
DISCO:半导体切磨抛领域的领航者
DISCO,作为全球领先的精密加工设备制造商,其在半导体切割、研磨、抛光等多个环节的技术与产品,长期以来都是行业内的标杆。DISCO依靠技术创新和持续研发,不断推出高性能、高精度的切磨抛设备,满足了半导体行业日益增长的工艺需求。

来源:DISCO官网
咨询电话:13522079385
DISCO 的大部分产品已被广泛应用于半导体芯片制造工序,涉及硅片制造、晶圆制造( 前道)和封装测试(后道)各环节:
硅片制造环节:DISCO 研磨机用于减薄从硅锭切割的晶圆,随着半导体芯片变得更薄且功能更高,减薄过程中的平面度精度变得越来越重要。
晶圆制造环节:DISCO 表面平坦机是通过金刚石创刀进行创削加工,实现对延展性材料(Au、Cu、焊锡等 ),树脂(光刻胶,聚酰亚胺等),以及其他复合材料的高精度平坦化,可替代 CMP 的部分工序,提高生产效率及降低成本。
封装测试(后道)
背面减薄环节:DISCO 背面研磨机用于晶圆的背面研磨以使其变薄,同时保护正面的电路;损坏的层可以通过抛光去除以提高减薄晶片的强度,在此过程中DISCO抛光机则可大显身手。而晶圆贴膜机是为了处理12寸超薄晶圆,特意与背面研磨机组成联机系统的晶圆贴膜机,针对研磨薄化后的晶圆,可安全可靠地实施从粘贴切割胶膜到框架上,再到剥离表面保护胶膜为止的一系列工序,是一项实现高良率薄型化技术的专用设备。
晶圆切割环节:DISCO切割机用于将晶圆切割成一颗颗独立的裸片(die ),随着芯片尺寸的持续微缩和性能的不断攀升,芯片的结构越来越复杂,芯片间的有效空间日益缩小,切割难度逐步提升,这对于精密切割晶圆的划片设备的技术要求越来越高,除了传统的刀片切割之外,近年来业内使用激光切割技术的比例大有上升趋势,DISCO在此拥有充足且领先的布局。在芯片封装在树脂中后,DISCO 芯片分割机也用于将其切割成一颗颗独立的芯片(chip)。
同时,DISCO 还建立了完善的售后服务体系,为客户提供全方位的技术支持,例如定期维护、设备升级等,确保设备始终处于最佳状态。
金刚石&半导体切磨抛
金刚石工具为半导体加工关键耗材,DISCO 为行业龙头。金刚石工具广泛应用于半导体各加工环节。金刚石工具是指以金刚石及其聚晶复合物为磨削单元,借助于结合剂或其它辅助材料制成的具有一定形状、性能和用途的制品,广泛应用于半导体、陶瓷、玻璃等硬脆材料的磨削切割、抛光加工。
在半导体的前道加工工序中,金刚石工具用途包括:切割,包括晶棒截断与切片。

来源:网络
电镀金刚石带锯或内圆切割片均可用于晶棒截断,但内圆或外圆切割效率低、材料损失率大、加工质量低,故目前多采用金刚石带锯来切割晶棒。
晶棒切片的方法主要包括内圆切割和线切割,线切割相较内圆切割具有效率高、切割直径大及锯痕损失小等优点,目前硅基半导体主要使用磨料线锯切割加工方式。
研磨与抛光:包括晶棒滚圆、晶圆片表面研磨、晶圆片边沿倒角与磨边,不同的研磨区域所需的研磨砂轮形状和厚度等参数不同。
在半导体的后道加工工序中,金刚石工具主要用于CMP修整器、背面减薄及划片。
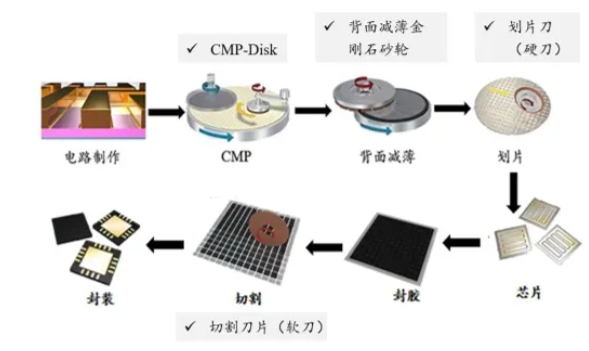
来源:网络
CMP(化学机械抛光)是半导体先进制程中的关键技术,是半导体硅片表面加工的关键技术之一,CMP-Disk(钻石碟)是CMP过程重要耗材:
CMP采用机械摩擦和化学腐蚀相结合的工艺,与普通的机械抛光相比,具有加工成本低方法简单、良率高、可同时兼顾全局和局部平坦化等特点。抛光垫表面的沟槽起着分布抛光液和排除废液的作用,抛光垫的表面粗糙度和平整度直接影响着CMP结果。抛光垫在CMP过程中易老化、表面沟槽易堵塞,从而使抛光垫失去抛光的作用。
此时需要CMP-Disk修整抛光垫的表面,使抛光垫始终保持良好的抛光性能,修整器起着去除抛光垫沟槽内废液、提高抛光垫表面粗糙度和改善抛光垫平面度的作用,以你次CMP-Disk的性能直接影响晶圆表面全局平坦化的效果。
划片刀一般由合成树脂、铜、锡、镍等作为结合剂与人造金刚石结合而成,主要分为带轮毂型(硬刀)及不带轮毂整体型(软刀)两大类,适用于加工不同类型材质的芯片及半导体相关材料。划片刀和减薄砂轮是半导体晶圆加工所用的主要金刚石工具。
国产化趋势
近年来,我国政府高度重视半导体产业发展,出台了一系列政策措施支持国产化进程。国家集成电路产业发展推进纲要明确提出要加快关键设备和材料国产化进程。国内企业也积极投入研发,取得了显著成果。例如,中微公司开发的刻蚀设备已成功应用于14nm制程,华锐光电的CMP设备也取得了突破等。
展望未来
展望未来,国产半导体切磨抛装备和材料将迎来更大的发展机遇。随着技术的不断突破和市场份额的逐步扩大,国产产品将有望实现自主可控,为我国半导体产业发展提供强有力的支撑。
半导体切磨抛装备和材料的国产化进程任重道远,但前景光明。相信在政府、企业和科研机构的共同努力下,我国将逐步摆脱对国外技术的依赖,实现自主可控,为建设科技强国贡献力量。
以上整理内容来源于华创证券行业研究报告