
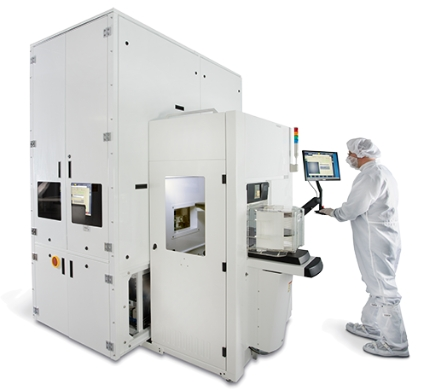
1063WAFERMILL™离子光束延迟解决方案
离子束制备
延迟器从上到下的全晶片上多个预选区域。整个过程都是完全自动化的;无需手动触摸晶圆。晶圆溶液支持计量学,包括CD-SEM样品制备。
MODEL 1063 WaferMill™ 离子束分层解决方案
从顶部开始对完整晶圆上的多个预选区域进行分层。全自动工艺支持半导体处理的所有阶段,适用于CD-SEM(关键尺寸扫描电子显微镜)样品制备。
Model 1063 WaferMill™ 离子束分层解决方案 规格说明
应用
近线和在线设备前端模块(EFEM)
设备前端模块(EFEM)
由Brooks Automation制造,包括以下组件:
300 mm前开式统一盒(FOUP)加载站,可容纳最多25片晶圆
配备被动末端执行器的四轴晶圆搬运机器人
预对准器,根据CD-SEM要求定位晶圆缺口
控制器单元
预抽真空室
300 mm VAT阀门接口,连接EFEM和负载锁
双波长紫外(UV)灯(253.7 nm 和 184.9 nm)安装在预抽真空室内
负载锁
300 mm VAT阀门接口,连接预抽真空室和工艺腔室
晶圆存在传感器指示晶圆是否在负载锁内
真空系统
两个专用涡轮分子泵:一个在预抽真空室,一个在工艺腔室
无油隔膜泵用于支持涡轮分子泵
配备真空计的压力监测
气动供应
负载锁和研磨腔室:
工艺气体:纯度99.999%的惰性气体(氩气);20至30 psi
控制气体:干燥氮气;60 ±5 psi
负载锁排气气体:清洁干燥空气(CDA);20至30 psi
自动气体控制:三个质量流量控制器(每个离子源一个)
MODEL 1063 WaferMill™ 离子束分层解决方案
从顶部开始对完整晶圆上的多个预选区域进行分层。全自动工艺支持半导体处理的所有阶段,适用于CD-SEM(关键尺寸扫描电子显微镜)样品制备。
工艺腔室
线性平台以5 µm精度在X和Y方向上移动晶圆
静电吸盘固定晶圆,通过消除晶圆弯曲提供均匀的研磨平面
晶圆存在传感器指示晶圆是否在工艺腔室内
基于KLARF文件的集成晶圆映射
离子源组件:三个离子源,间隔120°,位于水平面22.5°处。
可变能量操作(1.0至6.0 keV)
束流密度:10 mA/cm²
束斑尺寸:2 mm
点目标定位功能,可将晶圆驱动至任何点进行处理
转台/摇摆组件:
可摇摆±175°
角度偏差为±5°,步进范围0.1至2°
摇摆速度为1 rpm
自动终止
通过计时器
通过图像处理;当达到指定直径时停止研磨
用户界面
基于PC的界面:
可从EFEM和腔室侧访问
用于控制研磨过程
操作指示灯:堆栈灯
光学系统
用于束流过程监控和图像采集的光学系统:
视场:
15 mm(低倍率)
1.4 mm(高倍率)
电动变焦
电动聚焦
咨询电话:13522079385
EFEM电气要求
电气系统:200-240 VAC,50/60 Hz,单相(L1, L2, PE)
系统满载电流:20 A
恒定负载范围:5-14 A,取决于配置
过电压类别II
Jet电源分配单元配备10,000 AIC断路器;SCCR 10,000 A
室内真空:< 40 kPa(7 psi)
真空端口:8 mm快速连接
电源
208-240 VAC,50/60 Hz,5200瓦
保修
一年